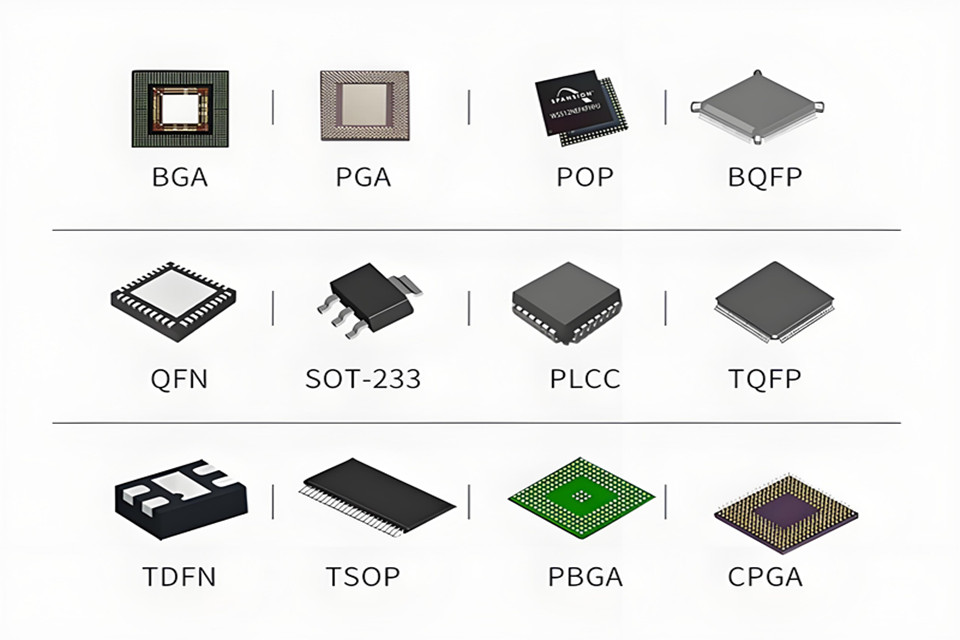
BGA vs QFP vs QFP
Avec le développement rapide de la technologie électronique, la technologie d'emballage des puces, en tant que lien central reliant les dispositifs semi-conducteurs et les cartes de circuits imprimés, affecte directement les performances, la fiabilité et le coût des équipements. BGA (Ball Grid Array), QFP (Quad Flat Package) et LGA (Land Grid Array) Il existe trois formes d'emballage principales, qui répondent à divers besoins d'application grâce à différentes structures physiques et caractéristiques de processus.
- Emballage BGA est réputé pour sa matrice de billes de soudure haute densité. Grâce à ses excellentes performances haute fréquence et à ses capacités de dissipation thermique, il est devenu le choix de prédilection pour le calcul haute performance, les communications 5G et les appareils mobiles ;
- Emballage QFP est basé sur une conception de broche à quatre côtés et est largement utilisé dans l'électronique grand public et les scénarios généraux avec son faible coût et ses avantages de détection facile ;
- Emballage LGA atteint une fiabilité accrue grâce à un réseau de contacts enfichables, en particulier dans le domaine des processeurs de bureau et du contrôle industriel.
Table of Contents
Cet article analysera en profondeur les principes, les avantages et les inconvénients ainsi que les scénarios d'application typiques de ces trois technologies d'emballage pour aider les ingénieurs et les développeurs à faire le meilleur choix en fonction des besoins réels.

Résumé de l'article
- boîtier BGA
- Caractéristiques: Il adopte un réseau de billes de soudure inférieures pour fournir haute densité d'E/S (le nombre de broches peut atteindre des centaines, voire des milliers), un faible délai de transmission du signal, une efficacité de dissipation thermique élevée et le volume est réduit de plus de 50% par rapport aux packages traditionnels.
- Avantages:Excellentes performances haute fréquence, forte stabilité mécanique, adapté aux scénarios à haute intégration (tels que les puces de serveur, les processeurs de smartphone).
- Inconvénients:Il ne peut pas être remplacé après le soudage, nécessite une inspection aux rayons X et présente des coûts de reprise élevés.
- Paquet QFP
- Caractéristiques:Disposition de broches à quatre côtés, processus mature, faible coût, adapté aux applications de densité moyenne et faible.
- Avantages: Détection intuitive, prise en charge du montage en surface SMT, adapté aux domaines électroniques généraux tels que les capteurs et les appareils à faible consommation.
- Inconvénients:Un petit espacement des broches entraîne des paramètres parasites élevés, une faible capacité de dissipation thermique et des performances haute fréquence limitées.
- Paquet LGA
- Caractéristiques:Il est connecté à la prise de la carte mère via le contact inférieur, prend en charge la conception enfichable et présente une grande fiabilité.
- Avantages: fortes capacités de gestion thermique, installation facile, bonne stabilité à long terme, largement utilisé dans les processeurs de bureau (tels que la série Intel LGA) et les systèmes de contrôle industriels.
- Inconvénients: grande taille, nécessite des prises supplémentaires et coût élevé.
Résumé:
- BGA convient aux scénarios avec des exigences de performances strictes (comme le calcul haute performance, les modules de communication) ;
- QFP est le premier choix pour les applications à faible coût et à usage général (telles que l’électronique grand public) ;
- LGA fonctionne bien dans les domaines qui nécessitent une évolutivité et une stabilité (comme les processeurs de bureau).
En comparant les performances électriques, la gestion thermique, le coût et la maintenabilité des trois, les ingénieurs peuvent choisir de manière flexible des solutions d'emballage en fonction des exigences du produit pour équilibrer les performances, le coût et la fiabilité.
Voici un tableau de comparaison des performances entre boîtier BGA et Paquet QFP
Comparaison des performances BGA et QFP
| Dimensions de comparaison | boîtier BGA | Paquet QFP |
|---|---|---|
| Densité d'E/S | Haute densité d'E/S, disposition de la matrice de billes de soudure, le nombre de broches dépasse de loin celui du QFP | Nombre moyen de broches, disposition à quatre côtés, adaptée aux applications de densité moyenne et faible |
| Performances électriques | Petit retard de transmission du signal, chemin de bille de soudure court, faible bruit, excellentes performances à haute fréquence | Paramètres parasites élevés, broches longues, performances haute fréquence limitées |
| Gestion thermique | Efficacité de dissipation thermique élevée, grande surface de contact de la bille de soudure, excellente conductivité thermique | Capacité générale de dissipation thermique, dépendant des broches et des matériaux d'emballage, haute résistance thermique |
| Fiabilité | Soudage coplanaire, connexion à bille de soudure stable, forte résistance aux contraintes mécaniques | Les broches sont faciles à casser, sensible aux contraintes mécaniques, faible fiabilité à long terme |
| Dimensions et poids | Petite taille, l'épaisseur est inférieure de 50% à celle du QFP, ce qui permet d'économiser de l'espace sur le PCB | Grande surface, broches exposées, adaptées aux applications avec espace libre |
| Coût de fabrication | Coût de fabrication élevé, équipement et processus de haute précision requis | Faible coût, processus simple, adapté aux produits milieu et bas de gamme |
| Détection et réparation | Détection difficile, Détection par rayons X requise, équipement professionnel requis pour la reprise | Détection intuitive, la qualité du soudage peut être vérifiée à l'œil nu, la reprise est relativement simple |
| Scénarios d'application | Scénarios hautes performances: CPU, GPU, puces de serveur, modules de communication 5G | Scénarios généraux: capteurs, électronique grand public, appareils basse consommation |
| Complexité du processus | Production automatisée, adapté à la fabrication à grande échelle | Le soudage manuel est réalisable, adapté aux petits lots ou au développement de prototypes |
| Adaptation de la dilatation thermique | Optimisation de l'adaptation thermique, réduisant le risque de fatigue des joints de soudure | Grande différence de dilatation thermique, facile à provoquer une défaillance du package en raison de la différence de température |
Ce qui suit est un tableau de comparaison des performances de boîtier BGA et Paquet LGA,

Comparaison des performances BGA et LGA
| Dimension de comparaison | boîtier BGA | Paquet LGA |
|---|---|---|
| Méthode de connexion | Tableau de balles, soudé au PCB via des billes de soudure inférieures | Réseau de pads, en contact direct avec les broches de la carte mère via les plots métalliques inférieurs |
| Remplaçabilité | Non remplaçable, difficile à démonter après soudure (nécessite une opération destructive) | Remplaçable, prend en charge la conception de plug-ins (nécessite un socket) |
| Performances de dissipation thermique | Efficacité de dissipation thermique élevée, les billes de soudure entrent directement en contact avec le PCB, chemin de conduction thermique court | Bonnes performances de dissipation thermique, dépend de la zone de contact entre les broches et les pads de la carte mère |
| Performances électriques | Petit retard de transmission du signal, chemin de bille de soudure court, excellentes performances haute fréquence | Faibles paramètres parasites, forte stabilité du signal, adapté aux applications haute fréquence |
| Volume et densité | Volume minimum, adapté à l'intégration haute densité (comme les appareils mobiles, les puces de serveur) | Volume légèrement plus grand, les broches occupent plus d'espace |
| Coût de fabrication | Faible coût, procédé de soudage automatisé mature, adapté à la production à grande échelle | Coût élevé, des équipements de soudage et des douilles de haute précision sont nécessaires |
| Procédé de soudage | Soudage coplanaire, un équipement de haute précision est nécessaire, la qualité du soudage est contrôlée par la température | Soudage par enfichage, la connexion est réalisée via des douilles et le processus de soudage est plus stable |
| Fiabilité | Haute fiabilité, connexion à bille de soudure stable, forte résistance aux contraintes mécaniques | Haute fiabilité, grande surface de contact entre les broches et les pastilles, bonne stabilité à long terme |
| Taux de finition | Faible taux de finition, les écarts de soudage conduisent facilement à la ferraille | Taux de finition élevé, une qualité de soudage plus contrôlable |
| Scénarios d'application | Scénarios hautes performances: CPU, GPU, module de communication 5G, puce serveur | Scénarios évolutifs: CPU de bureau, contrôle industriel, équipement électronique qui doit être remplacé fréquemment |
| Adaptation de la dilatation thermique | Optimisation de l'adaptation thermique, réduire le risque de fatigue des joints de soudure | Grande différence de dilatation thermique, une compensation matérielle supplémentaire est requise |
| Détection et réparation | Détection difficileUne détection par rayons X est nécessaire et un équipement professionnel est requis pour les retouches. | L'inspection est intuitive, la qualité du soudage peut être vérifiée visuellement et la reprise est relativement simple |
Domaines d'application typiques
- Emballage BGA: –Appareils mobiles: Smartphones, CPU/GPU d'ordinateur portable
- Serveur:Puces de calcul haute performance, contrôleurs de stockage
- Communications 5G: Modules RF haute fréquence, puces de station de base
- Emballage LGA:
- Ordinateur de bureau: CPU évolutif (tel que Intel LGA 1700)
- Contrôle industriel:Systèmes embarqués qui doivent être remplacés fréquemment
- Marché du bricolage: Conception de carte mère prenant en charge le remplacement par l'utilisateur
Résumé de la comparaison des boîtiers BGA, QFP et LGA
Emballage BGA (Réseau de grilles à billes) utilise réseau de billes de soudure pour atteindre haute densité d'E/S et performances haute fréquence, qui convient à scénarios de haute performance (tels que le CPU, le GPU, les modules de communication 5G), mais présente les inconvénients de non remplaçable et difficile à détecter; Emballage QFP (Forfait Quad Flat) adopte un broche à quatre côtés conception, qui est peu coûteuse et intuitif à détecter, mais a paramètres parasites élevés et faible gestion thermique, et convient pour électronique grand public (tels que les capteurs et les appareils à faible consommation) ; Paquet LGA (Réseau terrestre) contacte les broches de la carte mère via un réseau de pads, prend en charge remplaçabilité et haute fiabilité, et est couramment utilisé dans processeurs de bureau et contrôle industriel, mais est de grande taille et coût élevé.